與我們聯絡
與 Tek 業務代表即時對談。 上班時間:上午 6:00 - 下午 4:30 (太平洋時間)
請致電
與 Tek 業務代表即時對談。 上班時間:上午 8:30 - 下午 5:30 (太平洋時間)
下載
下載手冊、產品規格表、軟體等等:
意見回饋
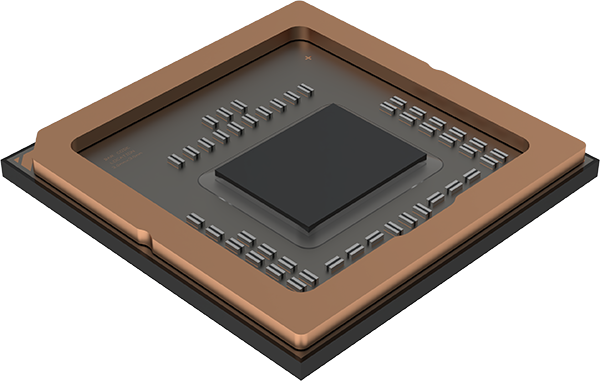
簡易、專家、完成
Tektronix 是您團隊的延伸,提供量身打造的校正服務解決方案,可節省時間、節省成本,確保電子測試與量測設備的準確性。我們在擴大或外包複雜的測試與量測設備校正方面配合您, 協助您做出最聰明的的業務決策每天都有數千家公司仰賴 Tektronix,以具競爭力的市場價格提供 OEM 品質校正。
- 服務 Tektronix、Keithley、Fluke、Keysight、Rohde & Schwartz、Agilent、+9000 個其他測試與量測設備品牌
- 量身打造的方案選項:現場、當地運送至工廠
- 快速、可靠的周轉時間
- 完整 Z540 和 ISO 17025 認可校正系列
- A2LA 認可技師
簡易、專家、完成
Tektronix 是您團隊的延伸,提供量身打造的校正服務解決方案,可節省時間、節省成本,確保電子測試與量測設備的準確性。我們在擴大或外包複雜的測試與量測設備校正方面配合您, 協助您做出最聰明的的業務決策每天都有數千家公司仰賴 Tektronix,以具競爭力的市場價格提供 OEM 品質校正。
- 服務 Tektronix、Keithley、Fluke、Keysight、Rohde & Schwartz、Agilent、+9000 個其他測試與量測設備品牌
- 量身打造的方案選項:現場、當地運送至工廠
- 快速、可靠的周轉時間
- 完整 Z540 和 ISO 17025 認可校正系列
- A2LA 認可技師
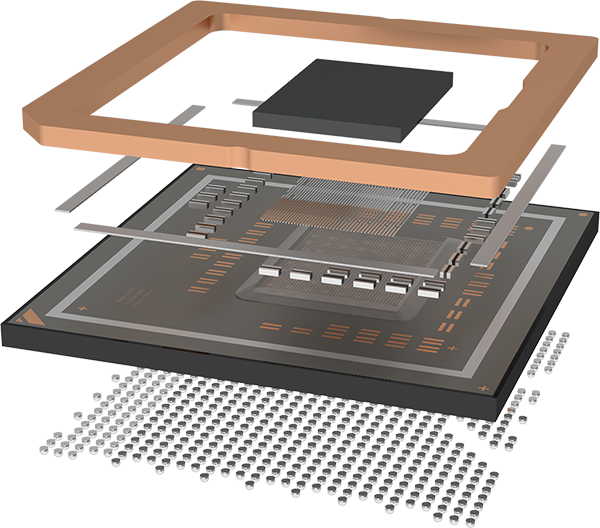

簡易、專家、完成
Tektronix 是您團隊的延伸,提供量身打造的校正服務解決方案,可節省時間、節省成本,確保電子測試與量測設備的準確性。我們在擴大或外包複雜的測試與量測設備校正方面配合您, 協助您做出最聰明的的業務決策每天都有數千家公司仰賴 Tektronix,以具競爭力的市場價格提供 OEM 品質校正。
- 服務 Tektronix、Keithley、Fluke、Keysight、Rohde & Schwartz、Agilent、+9000 個其他測試與量測設備品牌
- 量身打造的方案選項:現場、當地運送至工廠
- 快速、可靠的周轉時間
- 完整 Z540 和 ISO 17025 認可校正系列
- A2LA 認可技師
Lean Manufacturing
Tektronix Component Solutions applies lean manufacturing principles throughout our facility and is focused on continuous improvement to remove waste, streamline processes and ensure that assembly activities are providing value to our customers. To support this goal, our manufacturing lean cells are constantly evaluated on strict standards of safety, quality, delivery, inventory and productivity (+QDIP). +QDIP metrics are clearly communicated at each cell by a visual management system, allowing managers and operators to quickly assess performance at any given time. With these metrics as a guide, our manufacturing team consistently seeks to pro-actively enhance the design and flow of lean cells to improve performance (e.g. takt time, yield, throughput). This focus on continuous improvement helps to proactively reduce risk and ensure quality and consistent delivery.


As a proven US-based, ITAR-registered supplier to a variety of defense programs and companies, Tektronix Component Solutions is an ideal partner for defense applications requiring high-performance, mission-critical microelectronics. Offering services and products that include wafer test, IC packaging assembly and test, 2.5/3D packaging, and design & simulation, Tektronix Component Solutions has the expertise and capabilities to meet your requirements for high-reliability microelectronics.
With more than 40 years of experience, Tektronix Component Solutions is the stable supplier that you can trust to deliver on long-term military programs.
Trusted, ITAR-Registered Supplier
Tektronix Component Solutions has been accredited by the U.S. Department of Defense (DOD), Defense Microelectronics Agency (DMEA) as a Category 1A microelectronics Trusted Source for IC packaging/assembly and test services – the highest designation awarded by the U.S. Department of Defense. This enables Tektronix Component Solutions to serve U.S. defense customers with classified program requirements. The accreditation certifies that Tektronix Component Solutions meets stringent product control and security standards in providing trusted microelectronic services. Tektronix Component Solutions also holds certifications in ISO9001/ISO14001 and AS9100D and meets all ITAR requirements.
As an on-shore, ITAR-registered supplier, Tektronix Component Solutions has stringent standards in-place to protect and control sensitive information related to defense programs. With many years of experience supporting defense customers and programs, we recognize and adhere to the added level of responsibility in providing microelectronic engineering and manufacturing services to the military.

High-Performance Products and Services
Our military experience spans a variety of critical applications, including communications, avionics, radar, propulsion control, and guidance systems. Tektronix Component Solutions has supplied high-performance and high-reliability products to defense programs such as the F-22 Raptor and F-35 Lightning II (Joint Strike Fighter) with a focus on continual C-SWaP (cost, size, weight and power) improvements.
Having served military and commercial aerospace customers for many years, Tektronix Component Solutions has a deep understanding of the high-reliability requirements of those applications. As such, we fully utilize our unique strength in test to deliver fully-tested parts that have proven to operate successfully in mission-critical environments.


